Etching adalah jantung fabrikasi semikonduktor: pilihannya antara kimia basah yang sangat selektif dan plasma (dry etch) yang super‑direksional. Kuncinya? Kuasai laju etch, selektivitas, dan endpoint secara real‑time agar profil tetap presisi dan yield aman.
Industri: Semiconductor | Proses: Etching
Di balik gerbang logika nanometer, ada proses yang menentukan hidup‑mati sebuah pola: etching (pengikisan terkontrol). Versi basah mengandalkan larutan kimia dan cenderung isotropic (mengikis sama ke segala arah), sementara versi kering memanfaatkan plasma bertekanan rendah untuk mengukir secara anisotropic (lebih ke arah vertikal)—terutama lewat RIE (Reactive‑Ion Etching) dan DRIE (Deep RIE). Perbedaannya bukan sekadar filosofi; ini soal kimia reaksi, kontrol laju etch, hingga metrologi in‑situ yang menghentikan proses pada detik yang tepat.
Taruhannya besar. Segmen peralatan etch saja bernilai US$24,7 miliar pada 2024 dan diproyeksikan ~US$26,8 miliar pada 2025 (≈8,6% YoY), dengan pertumbuhan ~3–4% CAGR hingga 2032 menurut Stratview. Di atas panggung yang lebih luas, belanja peralatan pabrik wafer total sekitar US$100 miliar pada 2024, dengan China menyumbang ~US$41 miliar (Reuters).
Wet etching: selektivitas tinggi, arah bebas
Wet etching menggunakan bahan kimia cair untuk melarutkan material target dan secara alami isotropic, kecuali saat memanfaatkan anisotropi kristal (misalnya KOH pada silikon). Kekuatan utamanya adalah selektivitas: pemilihan reagen yang menyerang satu material namun hampir tidak menyentuh yang lain—misalnya buffered HF (BHF; HF + NH₄F) mengikis SiO₂ jauh lebih cepat ketimbang Si atau Si₃N₄ (corial.plasmatherm.com, halbleiter.org).
Contoh reaksi inti: SiO₂ + 6HF → H₂SiF₆ + 2H₂O (membentuk asam heksafluorosilikat yang larut) (microtechweb.com). Resep standar memberi kontrol laju: larutan BHF 6:1 (NH₄F:HF) mengikis thermal oxide ≈0,1–0,25 µm/menit pada suhu ruang (microtechweb.com). Oksida TEOS/PECVD—yang densitasnya lebih rendah—bahkan bisa mencapai ~350 nm/menit. Di sumber lain, laju thermal oxide kadang dilaporkan sekitar ~800 Å/menit (microtechweb.com).
KOH atau TMAH (basa kuat) mengikis Si secara anisotropic—bidang {100} lebih cepat dari {111}—yang cocok untuk V‑groove/vertikal di MEMS namun umumnya dihindari untuk lapisan IC (halbleiter.org). Produk samping biasanya larut (misal H₂SiF₆ dari HF) dan harus dibilas.
Kelebihan wet etch: throughput tinggi (alat batch), selektivitas material yang sangat baik (sering >100:1; halbleiter.org), biaya peralatan rendah, dan komposisi kimia mudah dituning. Trade‑off: anisotropi/kerataan profil lebih buruk (undercut masker; MDPI), terbatas pada lapisan yang bisa diakses cairan, serta risiko bahan kaustik seperti HF. Kontrol proses yang konsisten menuntut regulasi ketat suhu, konsentrasi, dan agitasi (spray vs immersion) demi menjaga laju etch konstan—laju biasanya meningkat saat suhu naik; kendali suhu menjadi kritikal (halbleiter.org, microtechweb.com).
Dry etching: dari plasma hingga ion milling
Dry etching memanfaatkan plasma bertekanan rendah untuk menghasilkan spesies reaktif dan ion terarah. Spektrumnya luas:
Plasma etch (tekanan tinggi, ~10⁻¹–10² Torr; Torr = satuan tekanan vakum): mean free path pendek, arah kedatangan bervariasi, etch dominan kimia dan relatif isotropic—cocok untuk cleaning atau blanket etch, jarang untuk transfer pola yang direksional (MDPI). Contoh: plasma SF₆/CF₄ menghasilkan radikal F yang menyerang Si membentuk SiF₄ volatil.
RIE (Reactive‑Ion Etching, ~10⁻³–10⁻¹ Torr dengan RF bias): ion berenergi mendapat momentum terarah untuk membangun anisotropi sambil bereaksi kimia. Ia “menggabungkan atribut plasma etch dan ion milling,” menghadirkan dinding vertikal plus selektivitas kimia (MDPI). Kimia khas: F‑based untuk SiO₂/nitride, Cl‑based untuk Si/Ge, dan Cl₂, BCl₃, atau fluorokarbon untuk logam (Semiconductor Engineering). Laju RIE bervariasi—puluhan nm/menit hingga ~µm/menit—dan cenderung melambat pada fitur dalam/aspek tinggi (loading effect karena difusi reaktan; MDPI).
ICP/ECR dan DRIE (plasma densitas tinggi) memisahkan kendali energi dan densitas ion, memungkinkan etch dalam dengan rasio aspek tinggi. Proses Bosch mengalternasi etch SF₆ dan pasivasi C₄F₈ untuk kedalaman >100 µm dengan AR >15:1 (MDPI). Alat komersial PlasmaTherm DRIE dilaporkan mencapai ~20 µm/menit pada Si dengan dinding nyaris vertikal dan minim scallop (MDPI). Untuk gambaran lain, deep RIE ke Si bisa ~500 nm/menit pada AR ~5:1, sedangkan etch kriogenik SiO₂ bisa <100 nm/menit (MDPI).
Ion milling (sputter fisik dengan gas inert seperti Ar, tekanan sangat rendah) ekstrem anisotropic namun tidak selektif, sehingga jarang dipakai untuk etch kritikal IC (MDPI, MDPI). Praktiknya, mayoritas fitur IC modern dipindahkan polanya dengan RIE/ICP, sedangkan wet etch dipakai untuk bulk removal/cleaning saat anisotropi tidak diperlukan.
Kimia etching dan produk samping
Etching pada dasarnya reaksi kimia—dengan atau tanpa plasma. Pada wet etch, produk reaksi harus larut. Contoh umum: SiO₂ dietch oleh HF yang membentuk heksafluorosilikat (H₂SiF₆; microtechweb.com). BHF (NH₄F/HF) mengontrol pH dan laju; BHF 6:1 mengikis thermal oxide ~100–250 nm/menit pada suhu ruang (microtechweb.com).
Si teretsa oleh KOH/TMAH panas via pembentukan kompleks silikat (anisotropi kristal: bidang (100) ~100× lebih cepat dari (111); halbleiter.org). Si₃N₄ butuh oksidator/asam kuat (misal H₃PO₄ panas) dengan laju rendah. Logam seperti Al dilarutkan oleh campuran asam (H₃PO₄:HNO₃:CH₃COOH), sementara Cu oleh oksidator berbasis peroksida atau amoniakal. Photoresist di‑strip dengan SPM (H₂SO₄:H₂O₂) atau O₂ plasma, menghasilkan CO₂/H₂O.
Pada wet etch, produk samping tidak boleh mengendap kembali. HF menghasilkan H₂ (gelembung) dan H₂SiF₆ yang larut (microtechweb.com); etch KOH membentuk silikat terlarut (halbleiter.org). Larutan biasanya diagitasi dan akhirnya dibuang sebagai limbah cair. Wet etch sangat selektif—HF menyerang oksida namun tidak Si atau sebagian besar logam (corial.plasmatherm.com, halbleiter.org), dengan rasio selektivitas sering >100:1.
Pada plasma etch, gas didisosiasi menjadi radikal dan ion. F, Cl, Br, atau O bereaksi dengan substrat; ion memberi momentum. Contoh: radikal F dari SF₆/CF₄ membentuk SiF₄ volatil pada Si; Cl₂/BCl₃ membentuk klorida logam seperti AlCl₃; penambahan O₂ membantu mengoksidasi polimer; fluorokarbon (CF₄, CHF₃) dapat mendeposit pasivasi untuk membentuk sidewall (Bosch). Sputter inert (Ar) murni fisik. Atomic‑layer etch (ALE) yang emerging bersiklus adsorpsi (mis. Cl₂) lalu bombardir ion untuk melepas satu monolayer per siklus.
Apapun resepnya, produk samping harus volatil atau mudah dipompa. Jika residu non‑volatile terbentuk, cacat akan muncul.
Kontrol laju etch dan selektivitas
Laju etch (kedalaman per waktu) dan selektivitas (rasio laju etch material target terhadap material lain, mis. masker atau stop‑layer) adalah KPI utama (corial.plasmatherm.com). Untuk fitur presisi, laju tipikal puluhan hingga ratusan nm/menit; untuk trench dalam bisa ~µm/menit (MDPI, MDPI). Seiring kedalaman/rasio aspek naik, laju sering turun (batas difusi/“loading effects”; pengurangan bisa >50% saat area ter‑etch >~10% dari wafer; MDPI).
Selektivitas menentukan berapa lama etch bisa berjalan sebelum masker/lapisan bawah erosi. Di node maju, resist budget menyusut: spesifikasi selektivitas melonjak dari ~2:1 ke ~10:1 hanya dalam beberapa generasi menurut imec (Semiconductor Engineering). Kekurangan selektivitas memaksa masker lebih tebal/mahal. Pada praktiknya, engineer mengorbankan sedikit laju demi uniformity dan kontrol profil; endpoint detection (lihat bagian berikut) meminimalkan over‑etch.
Monitoring in‑situ dan endpoint real‑time
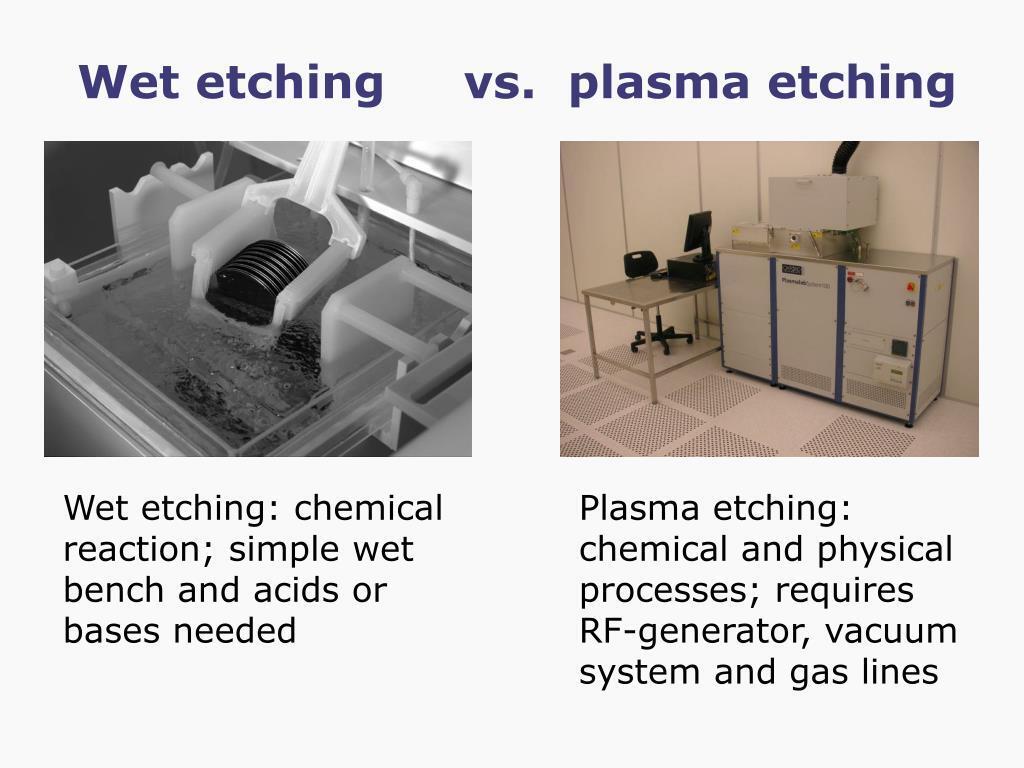
Endpoint adalah momen emas. Lam Research menekankan: overrun ke lapisan bawah bisa merusak yield. Sensor in‑situ di dalam chamber memungkinkan penghentian seketika saat lapisan habis.
Toolkit paling umum: OES (Optical Emission Spectroscopy; spektroskopi emisi optik) memantau cahaya plasma, mendeteksi perubahan intensitas garis emisi gas/byproduct saat lapisan berganti—non‑invasif dan luas dipakai (ResearchGate, Lam Research). Interferometri/ellipsometri berbasis laser melacak ketebalan film via fringe interferensi; Samara dkk. menunjukkan interferometer in‑situ yang memanfaatkan emisi plasma alami di antara elektroda untuk memantau uniformity (ResearchGate).
Sensor akustik/getaran kadang digunakan; sinyal listrik/IT seperti arus/tegangan RF atau perubahan tekanan juga menjadi indikator. Tren terbaru: citra RGB sederhana dari kamera melalui jendela chamber plus model neural network dapat memprediksi kedalaman etch dengan akurat—“virtual sensor” berbasis ML; Kang dkk. (2025) menonjolkan kemampuan BNN untuk ketidakpastian yang andal (arXiv).
Metrologi in‑situ membuka jalan feedforward/feedback real‑time dan endpoint yang tepat, ketimbang mengandalkan metrologi offline. Dengan “hampir setengah langkah proses fab” kini melibatkan plasma etching (Semiconductor Engineering), integrasi sensor adalah standar. Seperti disorot Lam Research: metrologi standalone tak bisa mencegah overdosed etch; sensor terintegrasi memungkinkan koreksi proses real‑time.
Dampak kinerja, pasar, dan regulasi
Kontrol etch yang ketat diterjemahkan langsung ke yield dan biaya. Profil yang seragam dan presisi memastikan fungsi listrik (dari lebar fin gate hingga kedalaman via). Selektivitas tinggi memangkas biaya masker dan defectivity; imec mencatat lonjakan kebutuhan selektivitas dari ~2:1 ke ~10:1 memunculkan tantangan 4–5× (Semiconductor Engineering). Satu foundry besar bahkan menghemat berbulan‑bulan uji etch dengan model prediktif ML (Semiconductor Engineering).
Dari sisi pasar, dry etch dan cleaning tools disebut sebagai area berpertumbuhan tinggi (Reuters), sementara vendor terdepan (Lam, Applied, TEL, dll.) menegaskan kebutuhan selektivitas dan presisi yang makin meningkat seiring skala node (Semiconductor Engineering).
Kimia etch juga membawa kewajiban lingkungan. Bahan seperti HF, HCl, H₂SO₄, NH₄OH tergolong B3 (bahan berbahaya dan beracun) di Indonesia di bawah PP 74/2001 yang mengimplementasikan UU 32/2009 (Enviliance). HF sendiri menyumbang sekitar 40% pelepasan bahan berbahaya dari sebuah fab chip (MDPI), sehingga praktik umum di fab adalah mendaur ulang HF atau menetralkannya (mis. mengendapkan CaF₂) sebelum pembuangan. Fasilitas modern menggunakan sistem netralisasi (kontrol pH), scrubbing, dan filtrasi; injeksi bahan penetral dapat dilakukan dengan akurasi menggunakan peralatan seperti dosing pump, sementara partikel dapat disaring pada loop filtrasi menggunakan cartridge filter. Perangkat bantu utilitas proses semacam ini lazim ditempatkan dalam paket water treatment ancillaries untuk integrasi ke fasilitas.
Ringkasan teknis inti
Kesimpulannya sederhana namun menentukan: wet etch unggul pada selektivitas material (sering >100:1) namun cenderung isotropic, sedangkan dry etch—terutama RIE/DRIE—memberi etch directional dengan dinding vertikal. Laju etch perlu dijaga dalam rentang puluhan–ratusan nm/menit untuk fitur presisi, dan bisa ~µm/menit untuk etch dalam, dengan kewaspadaan pada loading effects yang bisa memangkas laju >50% ketika area terbuka melebar. Kontrol suhu, komposisi gas/larutan, tekanan, bias RF, dan kondisi chamber adalah kenop proses utama; “laju sering meningkat saat suhu naik,” sehingga kendali suhu yang ketat krusial (halbleiter.org). Endpoint in‑situ—mulai OES, interferometri, hingga “virtual sensor” berbasis ML—berperan sentral untuk berhenti tepat waktu (ResearchGate, Lam Research, arXiv). Dengan hampir setengah langkah proses fab melibatkan plasma etching (Semiconductor Engineering), kombinasi kimia yang tepat dan metrologi terintegrasi bukan lagi opsi—melainkan syarat bertahan.
